Реферат: Микроинтерферометрия для контроля и оценки трехмерных дефектов
Свет от источника 1 проходит через конденсор 2 и диафрагму 3. Зеркало 4 делит его на два когерентных пучка, один из которых фокусируется объективом 5 на эталонное зеркало 6, а другой объективом 5' на контролируемую поверхность 7. После отражения от эталона и изделия пучки проходят через те же элементы схемы и фокусируются линзой 8 в плоскости диафрагмы 9, в которой с помощью окуляра 10 наблюдают интерференционную картину 11 взаимодействия эталонного и рабочего пучков света. При этом наблюдают чередующиеся светлые и тёмные полосы интерференции, искривлённые в соответствии с профилем исследуемой поверхности. Кривизну полос измеряют, например, с помощью окуляр-микрометра. Она является количественной характеристикой микронеоднородностей поверхности изделия: искривление на одно расстояние между одноцветными полосками соответствует глубине или высоте дефекта, равной одному периоду световых колебаний или в линейном размере - длине волны используемого света.

Рис. 1. Оптическая схема микроинтерферометра Линника:
1 - осветитель; 2 - конденсор; 3,9 - диафрагмы; 4 – светоделительное полупрозрачное зеркало; 5,5' - микрообъективы; 6 - эталонное зеркало; 7 - исследуемая поверхность; 8-10 - окуляр; 11 - наблюдаемая интерферограмма
Интерференционным способом производится измерение неплоскостности стеклянных пластин фотошаблонов. Этому способствует высокая чистота поверхности стекол, позволяющая получить чёткую интерференционную картину. Этим способом исследуется поверхность полированных полупроводниковых пластин. Для этого используют призменный интерферометр, изображённый на рис.2. С его помощью может быть измерена неплоскостность (прогиб) пластин и некоторые поверхностные дефекты.

Рис. 2. Схема призменного интерферометра:
1 - полупроводниковая пластина; 2 - стеклянная призма; 3 - экран (матовое стекло); 4 - лазер; 5,6 - коллиматор; 7 - регулировочный винт; 8 - вакуумный прижимной столик
Интерференционная картина выводится на телевизионный экран (рис. 3). Отклонение определяется по числу интерференционных полос (колец) на экране телевизионного интерферометра (рис. 4).

Рис. 3. Интерферограммы на экране телевизионного интерферометра

Рис. 4. Внешний вид цифрового телевизионного интерферометра ZygoMarkII
Контроль толщины диэлектрических плёнок интерференционными методами. В технологии производства ИС для ЭА и СМЭ на основе кремния операция термического окисления стоит на первом месте в цепи технологических операций по созданию топологического рисунка. Далее в ходе изготовления ИС эта операция повторяется несколько раз. Толщина слоя диэлектрика редко превышает 1 мкм и обычно находится в пределах 0,1-0,6 мкм. Учитывая задачу контроля толщины, следует отметить, что стабилизация скорости термических процессов осаждения плёнок технически сложна, и если возможна, то при наличии сигнала обратной связи, информирующего о наращиваемой толщине. С учётом высоких температур и кислородной среды наиболее перспективными для указанных процессов являются неконтактные оптические способы измерений, использующие явление интерференции в плёнке: метод отражательной интерференции с автоматическим отсчётом толщины плёнки и с визуальным цветовым контролем.
Метод отражательной интерференции основан на регистрации интерференции отраженных от подложки с пленкой когерентных лучей света с известной длиной волны и определении толщины наносимой пленки по интенсивности суммарного светового потока. Он заключается в следующем. На поверхность подложки с плёнкой направляется луч света от монохроматического источника (обычно лазера). На поверхности раздела «окружающая среда - плёнка - подложка» луч претерпевает отражение и преломление (рис. 5).
Отражённый от поверхности плёнки луч I1 и вышедший из неё луч I2 имеют оптическую разность хода, пропорциональную удвоенной толщине контролируемой плёнки
S = n2(AD+DC) - n1BC ~ 2h .
При нормальном падении луча I0
S = 2hn2 .
Для первого гашения выходного пучка света в результате интерференции лучей I1 и I2 необходимо условие
S = /2 ,
откуда можно определить толщину плёнки:
h = /4n2 .

Рис. 5. Ход лучей в системе «плёнка-подложка» при измерении толщины плёнки
Это лежит в основе принципа действия лазерного интерференционного прибора для контроля толщины диэлектрических плёнок в процессе их нанесения (рис. 6). Суммарный оптический сигнал после интерференции этих лучей в процессе роста плёнки будет иметь осциллирующую форму (рис.7). Этот сигнал регистрируется и преобразуется в электрический с помощью фотоприёмника. Процесс наращивания диэлектрического слоя контролируют по зависимости I=f(t), которая регистрируется либо самописцем, либо графическим дисплеем с памятью. Толщине наносимой плёнки, соответствующей расстоянию между двумя экстремальными точками экспериментальной зависимости I=f(t), будет соответствовать разность хода лучей I1 и I2 , на которой укладывается половина длины волны используемого монохроматического излучения. Отсчитывая временной интервал от начала процесса и зная длину волны источника излучения и показатель преломления n2 , по кривой I=f(t) можно регистрировать текущее значение толщины наносимой на подложку плёнки.
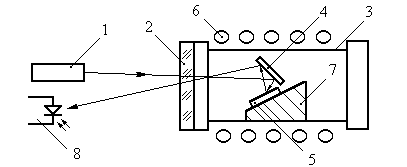
Рис. 6. Оптическая схема лазерного интерференционного прибора для контроля толщины диэлектрических плёнок:
1 - лазер; 2 - оптическое окно; 3 - трубчатый реактор; 4 - зеркало; 5 - пластина; 6 - ВЧ-индуктор; 7 - графитовый нагреватель; 8 – фотоприёмник
--> ЧИТАТЬ ПОЛНОСТЬЮ <--