Курсовая работа: Методы получения тонких пленок
По существу коэффициент распыления представляет собой среднее число атомов мишени, выбитых одним ионом. Коэффициент распыления зависит от энергии ионов Еи , его массы (рода рабочего газа), материала мишени и в некоторой степени от ее температуры и состояния поверхности, угла бомбардировки, давления газа (при условии, что давление не выходит за пределы, при которых газоразрядная плазма гаснет).
1.2.2 Трехэлектродная система распыления
Для повышения чистоты получаемой на подложке пленки процесс ионно-плазменного распыления необходимо проводить при как можно меньшем давлении рабочего газа. Однако, как уже отмечалось ранее, понижение давления приводит к тому, что при большой длине свободного пробега электронов вероятность их столкновения с атомами рабочего газа становится ничтожно малой, и газовый разряд гаснет. Поэтому для поддержания разряда в камере и обеспечения распыления мишени при низких давлениях необходимы специальные меры.
Одним из вариантов решения проблемы является применение трехэлектродной системы распыления, изображенной на рис. 3. Цифрами на рисунке обозначены: 1 – термокатод; 2 – анод; 3 – мишень; 4 – подложка; 5 – подложкодержатель. Таким образом, в данной системе имеются три независимо управляемых электрода: термокатод, анод и распыляемая мишень, потенциал которой относительно термокатода составляет несколько киловольт.
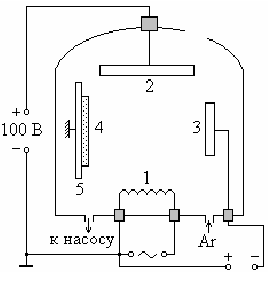
Рис 3. Трехэлектродная система распыления
По достижении в камере вакуума порядка10-4 Па термокатод разогревают и в камеру через натекатель подают инертный газ при давлении 0,05 - 1 Па. В результате термоэлектронной эмиссии с катода будут интенсивно испускаться электроны, ускоряющиеся вертикальным электрическим полем. При напряжении между термокатодом и анодом порядка 100 В возникает несамостоятельный газовый разряд, при этом разрядный ток достигает нескольких ампер. Мишень, имеющая отрицательный потенциал относительно катода, оттягивает на себя значительную часть ионов, образующихся в газовом разряде, и ускоряет их. В результате бомбардировки мишени ионами происходит ее распыление, и распыленные атомы осаждаются на подложке, формируя тонкую пленку. Такие трехэлектродные системы, в которых электрические цепи разряда и распыления разделены и управляются независимо друг от друга, обеспечивают гибкость управления процессом. Скорость осаждения составляет единицы нанометров в секунду, что в несколько раз превышает аналогичный показатель для двухэлектродной схемы катодного распыления.
Дальнейшее развитие трехэлектродных систем распыления привело к использованию автономных ионных источников. Ионный источник представляет собой газоразрядную камеру с термокатодом, в которую подается рабочий газ под давлением ~ 0,5 Па, что обеспечивает высокую концентрацию ионов. Газоразрядная камера отделена от камеры осаждения калиброванными отверстиями, благодаря чему обеспечивается перепад давлений, и давление в камере осаждения, где расположены мишень и подложка, составляет ~ 0,015 Па. Часть ионов поступает через отверстия в камеру осаждения, ускоряется и распыляет мишень. Такая конструкция позволяет увеличить скорость распыления мишени и повысить чистоту осаждаемых на подложке пленок.
1.2.3 Высокочастотное распыление
Рассмотренные выше методы получения тонких пленок используют постоянные напряжения, прикладываемые к электродам системы распыления мишени. Это позволяет распылять мишени только из электропроводящих или полупроводниковых материалов. Если мишень выполнена из диэлектрика, то при ее бомбардировке положительно заряженными ионами на ней очень быстро будет накапливаться положительный заряд. Этот заряд создаст электрическое поле, которое будет тормозить бомбардирующие мишень ионы. Распыление мишени очень быстро прекратится.
Для распыления диэлектрической мишени необходимо между анодом и катодом-мишенью подавать переменное напряжение. В этом случае мишень поочередно будет обрабатываться потоками электронов и положительно заряженных ионов. При отрицательном потенциале на мишени будет происходить ее распыление ионами, а при положительном потенциале – нейтрализация заряда потоком электронов. Это в принципе позволяет распылять мишени из диэлектрических материалов, однако эффективность такого метода распыления будет невысокой.
Эффективность распыления можно значительно повысить, если между анодом и катодом-мишенью подать переменное напряжение частотой порядка 10 МГц (обычно используют частоту 13,56 МГц, разрешенную для технологических установок, работающих в этом частотном диапазоне). Повышение эффективности при высокочастотном распылении объясняется следующим образом. Масса электронов значительно меньше массы ионов. Поэтому, обладая значительно большей подвижностью, электроны успевают следовать за быстроменяющимся полем, переходя с одного электрода на другой. Ионы, будучи гораздо менее подвижными, не успевают заметно перемещаться в межэлектродном пространстве, в результате чего там образуется объемный положительный заряд ионов. Кроме того, количество электронов, поступающих на мишень за полпериода, значительно превышает то количество, которое необходимо для нейтрализации заряда ионов на мишени. В результате на диэлектрической мишени скапливается отрицательный заряд электронов. Все это приводит к появлению в межэлектродном пространстве дополнительного электрического поля, которое способно ускорить часть ионов до больших энергий, что и увеличивает эффективность распыления мишени.
Следует отметить еще одно важное обстоятельство. В условиях высокочастотного разряда заряженные частицы (электроны и ионы) совершают колебательное движение с амплитудой А, равной

где m - подвижность частицы, зависящая от давления газа; Е0 – амплитуда напряенности переменного электрического поля; w - циклическая частота питающего напряжения.
Если расстояние между электродами превышает амплитуду А, то на электроды поступают только те частицы, которые находятся от электрода на расстоянии, не превышающем А. При этом существенно, что в средней части разряда электроны совершают осциллирующие движения, эффективно ионизируя газ, поэтому высокочастотный разряд может существовать при более низких давлениях, и надобность в сложной трехэлектродной системы отпадает.
Благодаря пониженному давлению в газоразрядной камере, высокочастотные системы с успехом используют для распыления не только диэлектрических мишеней, но и мишеней из металлов и полупроводников.
1.2.4 Реактивное распыление
При реактивном распылении в газоразрядную камеру наряду с рабочим газом (обычно аргоном) добавляется небольшое количество реакционного активного газа (кислорода, азота и др.), в результате чего на подложке образуется пленка из химического соединения, образованного атомами мишени и активного газа. Если, например, мишень изготовлена из алюминия, а в качестве активного газа используется кислород, то на подложке получается пленка из оксида алюминия, если же в камеру добавляется азот, то получится пленка из нитрида алюминия.
Кроме оксидных и нитридных пленок, данным способом можно получать карбидные и сульфидные пленки, добавляя в камеру соответственно метан СН4 или пары серы. Для получения химического соединения необходимо строго определенное парциальное давление активного газа, зависящее от материала мишени. Поэтому чаще получаются не химические соединения, а твердые растворы. На основе одной мишени из какого-либо металла и различных активных газов можно получать широкую гамму свойств осаждаемых пленок – от проводящих и низкоомных резистивных до высокоомных резистивных и диэлектрических.
Использовать реактивное распыление взамен непосредственного распыления мишени из химического соединения целесообразно тогда, когда коэффициент распыления данного химического соединения (оксида, нитрида и так далее) низкий, либо тогда, когда технологически трудно изготовить массивную мишень из этого соединения. Кроме того, реактивное распыление создает условия для гибкого управления свойствами пленок при создании многослойных структур (например, пленочных конденсаторов).
В общем случае процесс осаждения пленок при реактивном распылении обусловлен тремя механизмами, действующими параллельно:
- образование химического соединения на поверхности мишени и его
распыление;
- образование химического соединения в пролетном пространстве "мишень - подложка" и осаждение его на подложку;
- взаимодействие осажденных на подложке атомов мишени с атомами активного газа.
В условиях невысокого давления газа в камере вероятность второго механизма весьма мала и его вклад в общий процесс формирования пленки на подложке незначителен. Что касается соотношения вкладов первого и второго механизмов, то это зависит от условий распыления, а именно, от рода материала мишени и от рода активного газа, от общего давления газовой смеси в камере и от парциального давления активного газа; от расстояния между мишенью и подложкой. На практике часто уменьшение давления парциального газа при прочих равных условиях увеличивает вероятность образования соединения непосредственно на подложке. В большинстве случаев необходимые реакции полностью протекают при содержании активного газа в газовой смеси (аргон + активный газ) порядка единиц процентов.
1.2.5 Магнетронное распыление
Стремление снизить давление рабочего газа в камере и увеличить скорость распыления мишеней привело к созданию метода магнетронного распыления. Один из возможных вариантов схем магнетронного распылителя представлен на рис. 4.