Реферат: Расчет параметров ступенчатого p-n перехода zip 860 kb
pро =Nэ , nnо =NБ , (1.2.1)
а концентрация не основных носителей определяется законом действующих масс:
nр0 =ni /pр0 =ni /Nэ (1.2.2.а)
pn0 =ni /nn0 =ni /NБ (1.2.2.б)
Индексы «p» и «n» соответствуют p- и n-областям, а индекс «0» соответствует состоянию термодинамического равновесия. Следует отметить, что концентрация не основных носителей в базе больше чем в эмиттере (а при Nэ >>NБ много больше). На рис. 1.2.а распределение примесей и носителей заряда представлено в полулогарифмическом масштабе.
Переход занимает область –lр0 < x < ln 0 . Конечно границы перехода x=-lp 0 и x=ln 0 определены в некоторой степени условно, так как концентрация основных носителей изменяется плавно. Тем не менее, из рисунка видно, что уже на небольшом расстоянии от границ внутри перехода выполняется равенство:
P<<Nэ , (1.2.3)
n<<NБ .
Неравенства (1.2.3) выполняется во всем p-n-переходе.
На рис. 1.2.б распределение концентрации носителей и примесей заряда изображены в линейном масштабе. Из рисунка видно, что в эмиттерной области перехода (-lp 0 <x<0) концентрация подвижных носителей очень мала по сравнению с концентрацией примеси. Эта область имеет отрицательный объемный заряд, плотность которого не зависит от координаты:
рэ = -lN э .
В базовой области перехода (0<x<lno ) плотность объемного заряда положительна:
pБ =lN б .
Для n-области основными носителями являются электроны, для p-области дырки. Основные носители возникают почти целиком вследствие ионизации донорных и акцепторных примесей.
Помимо основных носителей эти области содержат неосновные носители: n-область - дырки (pno ), p-область –электроны (nро ). Их концентрацию можно определить, пользуясь законом действующих масс:
nno ∙Pno =pno ∙nno =ni 2 . При nno =ppo =1022 м-3 и ni =1019 м-3 (для Ge)
получаем pno =nро =1016 м.
Таким образом, концентрация дырок в p-области на шесть порядков выше концентрации их в n-области, точно также концентрация электронов в n-области на шесть порядков выше их концентрации в p-области. Т.к. концентрация дырок в области p выше, чем в области n, то часть дырок в результате диффузии перейдет в n- область, где в близи границы окажутся избыточные дырки, которые будут рекомбинировать с электронами. Соответственно в этой зоне уменьшается концентрация свободных электронов, и образуются области нескомпенсированных положительных ионов донорных примесей. В p-области уход дырок из граничного слоя способствует образованию областей с нескомпенсированными отрицательными зарядами акцепторных примесей, созданными ионами.
Подобным же образом происходит диффузионное перемещение электронов из n-слоя в p-слой. Однако в связи с малой концентрацией электронов по сравнению с концентрацией дырок перемещением основных носителей заряда высокоомной области в первом приближении пренебрегают. Перемещение происходит до тех пор, пока уровни Ферми обоих слоев не уравняются [4].
 а)
а)
б)
в)
Рисунок 1.3 Физические процессы в полупроводнике: (а) – плоскость физического перехода; (б) – распределение концентрации акцепторной и донорной примеси в полупроводнике; (в) – объёмный заряд.
На рис. 1.3.б, показано изменение концентрации акцепторных и донорных атомов при перемещении вдоль оси Х перпендикулярной плоскости. Неподвижные объемные заряды создают в p-n-переходе контактное электрическое поле с разностью потенциалов, локализованное в области перехода и практически не выходящее за его пределы.
Поэтому вне этого слоя, где поля нет, свободные носители заряда перемещаются хаотично и число носителей, ежесекундно наталкивающихся на слой объемного заряда, зависит только от их концентрации и скорости их теплового движения, которое подчиняется классической статистики Максвелла-Больцмана.
На рис. 1.3.в показаны неподвижные объемные заряды, образовавшиеся в p-n-переходе.
Неосновные носители - электроны из p-области и дырки из n-области, попадая в слой объемного заряда подхватываются контактными полем Vк и переносятся через p-n переход.
Другие условия складываются для основных носителей. При переходе из одной области полупроводника в другую они должны преодолевать потенциальный барьер qVк , сформировавшийся в p-n-переходе. Для этого они должны обладать кинетической энергией движения вдоль оси Х, не меньшей qVк .
На первых порах, после мысленного приведения p- и n-областей в контакт, потоки основных носителей значительно превосходят потоки неосновных носителей. Но по мере роста объемного заряда увеличивается потенциальный барьер p-n-перехода, и потоки основных носителей резко уменьшаются. В тоже время потоки неосновных носителей не зависят от qVk и остаются неизменными. Поэтому относительно скоро потенциальный барьер достигает такой высоты, при котором потоки основных носителей сравниваются с потоками неосновных носителей.
Это соответствует установлению в p-n-переходе состояния динамического равновесия.
Из рис. 1.3.а видно, что в некоторой области Х=Хф концентрация электронов и дырок одинакова:
n0 (Хф ) = p0 (Хф ) = n
Эта плоскость называется плоскостью физического перехода в отличие от плоскости металлургического (или технологического) перехода Х= 0, где результирующая концентрация примеси равна нулю. В симметричных переходах плоскости физического и металлургического переходов совпадают.
1.3 Методы создания p-n-переходов.
Электронно-дырочные переходы в зависимости от технологии изготовления разделяются на точечные, сплавные, диффузионные, эпитаксиальные, планарные и другие.
1.3.1 Точечные переходы .
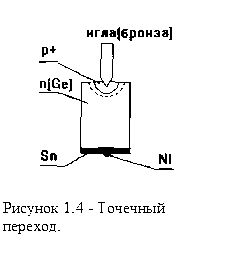 |
Образуются точечно-контактным способом (рис. 1.4.). К полированной и протравленной пластине монокристаллического полупроводника n-типа подводят иглу, например из бериллиевой бронзы с острием 20-30 мкм. Затем через контакт пропускают мощные кратковременные импульсы тока. Место контакта разогревается до температуры плавления материала зонда, и медь легко диффундирует внутрь полупроводника образуя под зондом небольшую по объему область p-типа. Иногда перед электрической формовкой на конец иглы наносят акцепторную примесь (In или Аl), при этом прямая проводимость контакта доходит, до 0,1 см. Таким образом, электронно-дырочный переход образуется в результате диффузии акцепторной примеси из расплава зонда и возникновения под ним области p-типа в кристаллической решетке полупроводника n-типа. Точечные переходы применяют при изготовлении высококачественных диодов для радиотехнического оборудования.
1.3.2 Сплавные переходы.
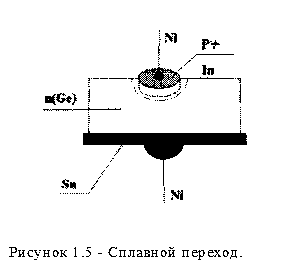 Обычно получают выплавлением примеси в монокристалл полупроводника (рис. 1.5.). Монокристалл, например, германия n-типа распиливают на пластины толщиной 200-400 мкм и затем после травления и полировки разрезают на кристаллы площадью в два-три миллиметра и больше. На кристаллы, помещенные в графитовые кассеты, накладывают таблетку акцепторного материала, чаще всего индия. Затем кассета помещается в вакуумную печь, в которой таблетка индия и слой германия под ней расплавляются. Нагрев прекращается и при охлаждении германий кристаллизуется, образуя под слоем индия слой p-типа. Застывшая часть индия представляет собой омический (невыпрямляющий) контакт, на нижнюю часть пластины наносят слой олова, который служит омическим контактом к германию n-типа. К индию и олову припаивают выводы обычно из никелевой проволочки.
Обычно получают выплавлением примеси в монокристалл полупроводника (рис. 1.5.). Монокристалл, например, германия n-типа распиливают на пластины толщиной 200-400 мкм и затем после травления и полировки разрезают на кристаллы площадью в два-три миллиметра и больше. На кристаллы, помещенные в графитовые кассеты, накладывают таблетку акцепторного материала, чаще всего индия. Затем кассета помещается в вакуумную печь, в которой таблетка индия и слой германия под ней расплавляются. Нагрев прекращается и при охлаждении германий кристаллизуется, образуя под слоем индия слой p-типа. Застывшая часть индия представляет собой омический (невыпрямляющий) контакт, на нижнюю часть пластины наносят слой олова, который служит омическим контактом к германию n-типа. К индию и олову припаивают выводы обычно из никелевой проволочки.