Реферат: Литография высокого разрешения в технологии полупроводников
- коэффициента поглощения резиста;
- толщины остаточного резиста;
- коэффициента отражения подложки;
- наличия усиливающего контраст слоя;
- интенсивности источника.
Процессы пошагового сдвига и совмещения оказывают основное влияние на производительность степпера. Использование мощных ртутных ламп или лазеров для метода экспонирования “вспышка на лету” позволит уменьшить время экспонирования до значений, меньших времени перемещения и совмещения. Толщина резиста и его коэффициент поглощения также влияют на производительность проекционной системы. Величина коэффициента поглощения резиста очень важна, так как определяет разрешение и скорость растворения резиста. Для уменьшения интерференционных эффектов на поверхность резиста или под него наносятся противоореольные слои, а также вводятся специальные примеси к резистам. Однако любые добавки к резистам или нанесение покрытия неизбежно будут поглощать излучение, и для компенсации эффекта внутренней фильтрации потребуется увеличение времени экспонирования. Интерференционные и дифракционные эффекты вызывают модуляцию интенсивности, и, следовательно, влияют на время экспозиции и ширину воспроизводимых линий. Экспонирование монохроматическим светом уменьшает дифракции Френеля, но усиливает эффект стоячих волн, которые возникают, если оптический путь кратен длине световой волны. В случае печати с зазором подбором зазора можно уменьшить эффект стоячих волн. Это достигается при следующих условиях:
n2=(n1n3)1/2, (19)
h2=l/4n2, (20)
где n1, n2, n3 - показатели преломления резиста вещества, заполняющего зазор, и подложки; h2 - величина зазора или толщина материала в зазоре.
Однако этот тип искажений гораздо сильнее проявляется при когерентном освещении.
В методе проекционной печати возможность контроля профиля и ширины воспроизводимых элементов рисунка фотошаблона определяется характеристиками проекционной оптики, контрастом резиста, коэффициентом отражения подложки и глубиной фокуса используемого объектива. Дифракция ведет к тому, что изображение полосок с промежутком 1.5 мкм подвержены сильному воздействию взаимного эффекта близости. Изменение профиля падающего пучка сильнее проявляется в искажении близко расположенных неэкспонируемых промежутков в позитивном резисте, нежели изолированной линии (рис.10).
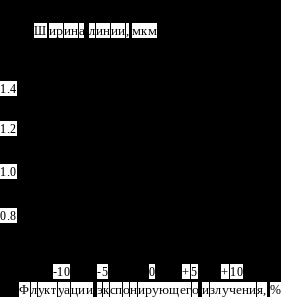
Рис. 10. Изменение ширины линии в резисте при недо- и переэкспониро-вании.
В изображениях, находящихся вне фокуса из-за ступенчатого рельефа или искривлений пластины, тоже происходит уменьшение интенсивности экспонирующего излучения. Расфокусирование ±1 мкм соответствует 20%-ым потерям интенсивности или отклонению ширины линии от требуемого значения на ±2 мкм, в то время как для обеспечения изменения ширины линии в пределах ±0.1 мкм возможное отклонение интенсивности излучения не должно превышать ±5%.
При проекционной печати происходит накопление пыли на поверхности фотошаблона. Количество пропечатанных дефектов можно уменьшить применением пленочных покрытий (тонкая пленка полимера), которые дефокусируют изображение частиц пыли, оказывающихся в этом случае на некотором расстоянии от поверхности фотошаблона.
Совмещение.
В процессе изготовления ИС на подложке формируются топологические слои, которые должны последовательно воспроизведены в заданных относительно друг друга позициях, определяемых разработчиком ИС. Для большинства ИС требования на допуск при совмещении составляют примерно 1/4 минимального разрешаемого размера элемента.
Существует два основных метода совмещения: от деленное от проекционного объектива (глобальное) и совмещение через проекционный объектив (локальное). Глобальное совмещение включает в себя вращательное и поступательное совмещение пластины и шаблона. Перепозиционирование осуществляется с использованием лазерных интерферометров или при помощи визуального определения положения пластины через контрольный объектив перед началом экспонирования.
Совмещение зависит от оптических свойств системы, плоскости поверхностей фотошаблона и подложки, а также вида меток совмещения и способов обработки сигнала рассовмещения.
Для распознавания и коррекции ошибок совмещения проводят измерения плоскостности пластин, ширины линий и совмещений, используя нониусы:
1) электрический тест - создаются проводящие слои для образования делителей напряжения;
2) оптический тест - регистрация интерференционного сдвига. Измеряется амплитуда дифрагировавшего когерентного света;
3) тест на качество края - регистрация лазерного излучения, отраженного от края структур;
4) микроскопический тест - при помощи сканирующего электронного микроскопа.
Фотошаблоны.
Процесс изготовления фотошаблонов важен для оптической литографии. В случае субмикронной оптической литографии с фотошаблоном 1х необходимо обеспечивать коррекцию размеров окон в сторону уменьшения на 0.5 мкм и контроль краев хромированных покрытий с точностью ±0.005 мкм. В настоящее время оригинал фотошаблона изготавливается методом ЭЛ-литографии. При изготовлении непрозрачного слоя фотошаблона могут быть использованы следующие материалы:
1) серебряная эмульсия;
2) обработанный ионами резист;
3) диазидные полимеры;